台股今日盤勢重點請點下列文章連結
文章架構
焦點事件:Apple下一代AI伺服器晶片將採用台積電SoIC封裝!
焦點個股:精材(3374)喜迎iPhone轉單,營運表現逐季增溫!
焦點事件:Apple下一代AI伺服器晶片將採用台積電SoIC封裝!
近期外資券商Morgan Stanley報告指出,蘋果(Apple)的下一代AI伺服器晶片將在2025下半年大量採用台積電(2330)的SoIC(系統整合單晶片,System-on-Integrated-Chips)封裝技術。
基於蘋果在2024年推出全新的AI功能Apple Intelligence,預期蘋果將會需要更多的伺服器來運行客戶回傳的大量數據,將會為台積電帶來龐大的訂單需求,蘋果有望在2025下半年增加3奈米的M3/M4 Ultra晶片訂單,並用來建置蘋果的資料中心。
蘋果預計最快將在M3/M4系列採用台積電的SoIC封裝技術,雖然目前蘋果還沒有在手機處理器上採用這項封裝技術,但只要未來M3/M4導入下列技術,SoIC將大量應用在蘋果的手機處理器上,隨台積電的2奈米製程同樣預計將在2025下半年進入量產,台積電將有更多的先進封裝訂單,客戶大量採用更將推動台積電對SoIC封裝技術進行擴產。
SoIC封裝未來將在手機晶片上被大量應用
CoWoS跟SoIC是台積電未來兩大先進封裝技術,兩者的差別在於,後者並沒有中介層,將小晶片(Chiplet)進行垂直堆疊(下圖a),並直接在晶片上進行鑽孔(TSV)來進行導電,因為會採用小晶片進行垂直堆疊,所以封裝後的晶片尺寸將會更小,更有利在手機、平板等消費性電子產品上使用,SoIC最大的考驗在於良率問題,因為SoIC會在晶片上直接進行鑽孔導電,製程難度較高,因此在過去並沒有太多客戶採用。
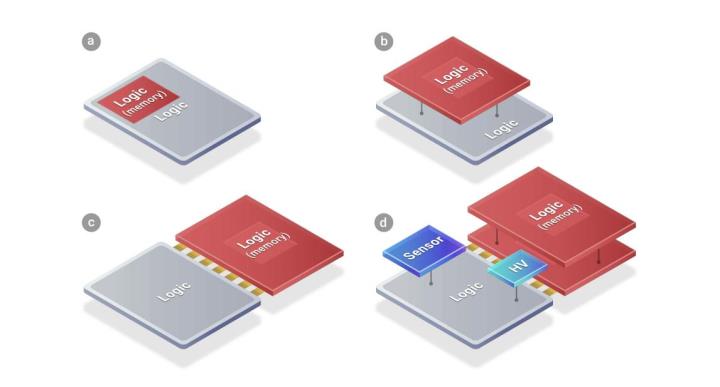
(圖片來源:TSMC)
想了解CoWoS封裝,請點下列文章連結
【產業研究報告】CoWoS供不應求,FOPLP加入戰場,設備股迎來營運爆發期!
過去台積電的SoIC的主要客戶是超微(AMD)的AI伺服器晶片MI300,AMD過去長期使用台積電的SoIC封裝技術,Morgan Stanley的報告中提到,在不斷的技術優化下,SoIC封裝的良率從最初低於50%,到目前為止已經可以達到90%,這樣的良率表現足以讓更多客戶願意使用台積電的SoIC封裝技術,良率問題改善將成為此次蘋果晶片導入SoIC最重要的關鍵。
台積電先進封裝產能供不應求
因為NVidia所有的高階AI晶片都要採用台積電的CoWoS封裝技術,導致台積電的CoWoS產能供不應求,即便從2023年開始公司就積極加速擴產,但仍然難以填補目前的訂單需求缺口,未來若是再加上蘋果的SoIC封裝訂單,台積電的產能有可能會持續吃緊。
台積電為了解決產能問題,除了積極擴廠外,公司也針對產能配置上進行調整,將公司重心放在CoWoS的前端封裝(Chip-on-Wafer,CoW封裝),然後將部分後段封裝訂單外包給其他封測廠,這將會為台灣的封測供應鏈帶來全新訂單動能。
台積電有望將部份產能外包,CMoney研究團隊更看好台積電的小金雞精材(3374),認為台積電將會把部分的Apple手機測試訂單轉單給精材,將為精材挹注強勁營運動能。
焦點個股:台積電小金雞精材(3374)喜迎轉單,營運表現逐季增溫!


 發表
發表


 我的網誌
我的網誌



